-
JP
-
ログイン

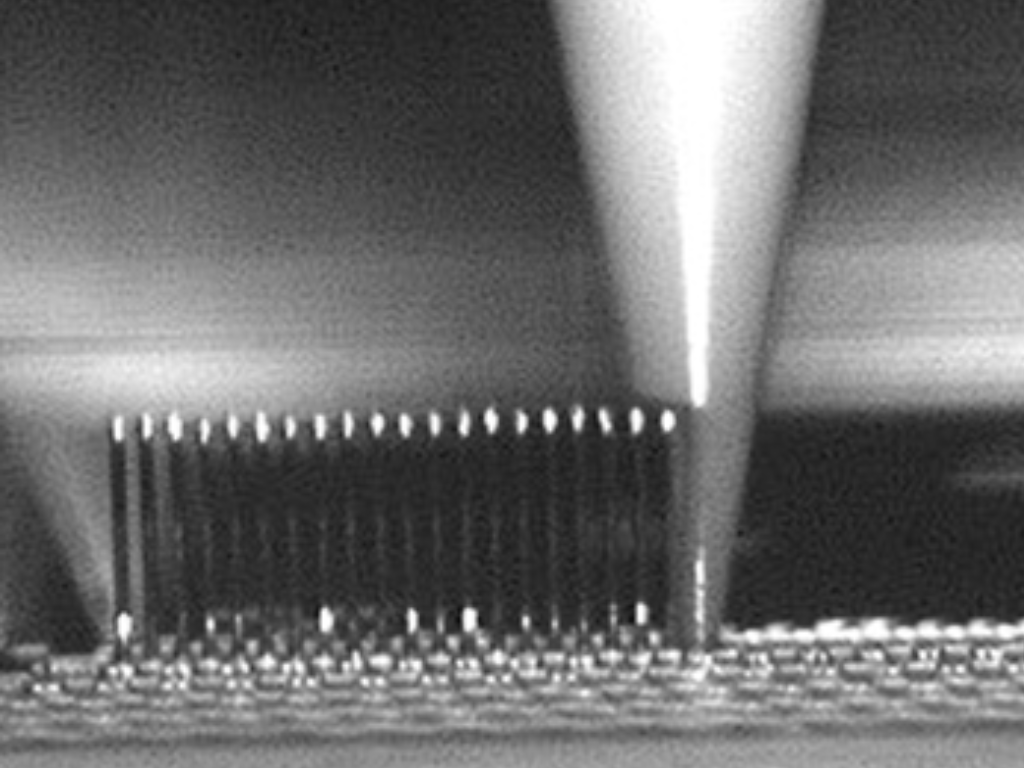
K&Sのキャピラリソリューションがもたらすバーチカルワイヤプロセスは、先端ICパッケージングのニーズに対応し、高密度なウェハおよび基板設計における信頼性の高いインターコネクトを実現するとともに、RFデバイス用途でも多く採用され、電磁干渉を最小限に抑えるメリットをもたらします。

「ProVertical Loop」プロセスは、最適化されたワイヤ高さとピッチコントロールにより、高精度なバーチカルワイヤボンディングを実現します。ワイヤ干渉や、セカンドボンドの不良を低減することで、プロセス全体の歩留まりを改善し、最大5%の生産性向上を達成します。
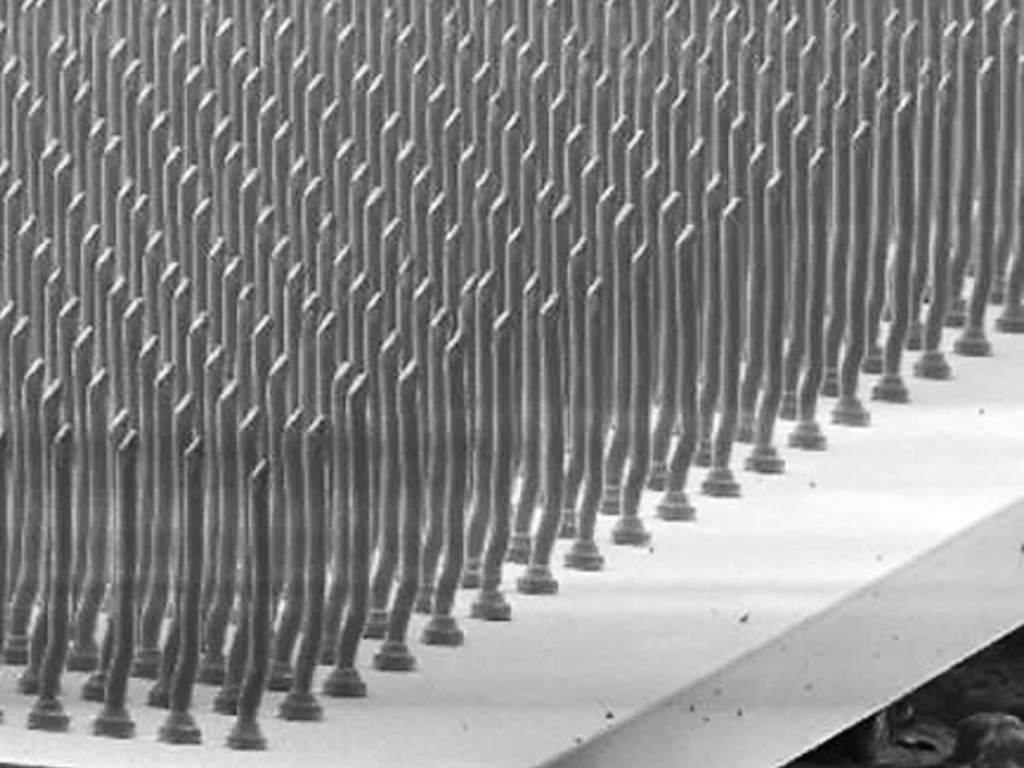
キャピラリは、パッケージの制約や各仕様に合わせて個別に最適化されており、キャピラリ、ワイヤ干渉と材料強度のバランスを両立しています。そのパフォーマンスはシミュレーションを通じて正確にモデリングされており、バーチカルワイヤ形成において安定した再現性の高い結果を保証します。

