Find what matters.
Search requires at least 3 characters
No result found
Quick links
Search requires at least 3 characters
No result found
Quick links


The TL Model is the perfect choice for bonding single-row to four-row matrix TO power devices. PowerFusion™’s industry leading productivity reduces your manufacturing costs and delivers superior bonding performance. It is upgradeable into the HL Model in case advanced interconnect requirements are needed in the future.

The HL Model is specially designed to enable large wire, small wire and PowerRibbon bonding in advanced interconnect designs. Whether you are bonding high density power devices like S0-8 & PDFN or synthesizing wire and ribbon in a matrix D-Pak, the superior indexing accuracy and advanced functions of the HL Model deliver consistent quality.

The HLx Model has all the high-performance capabilities of our HL Model with the added benefit of handling leadframes up to 105 mm wide. It is the most flexible platform for future leadframe development, the best choice for many applications.

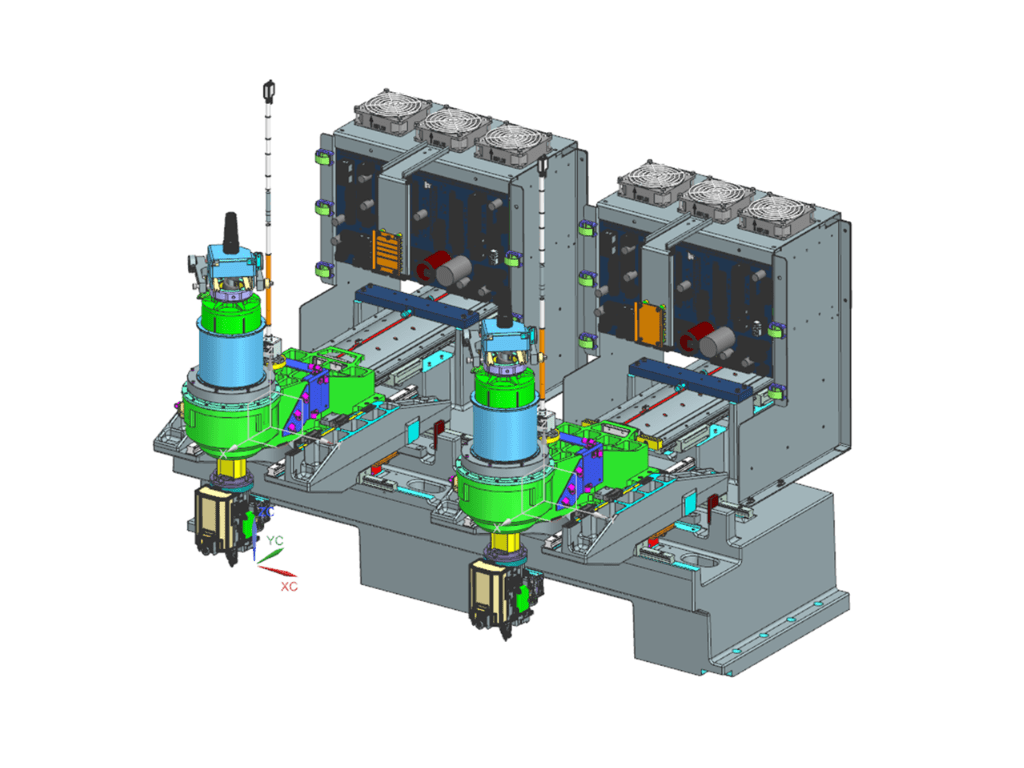
Increased UPH and higher MTBA.
Greater bond placement repeatability.
Ease of use.
Reduced preventive maintenance requirements on major components.
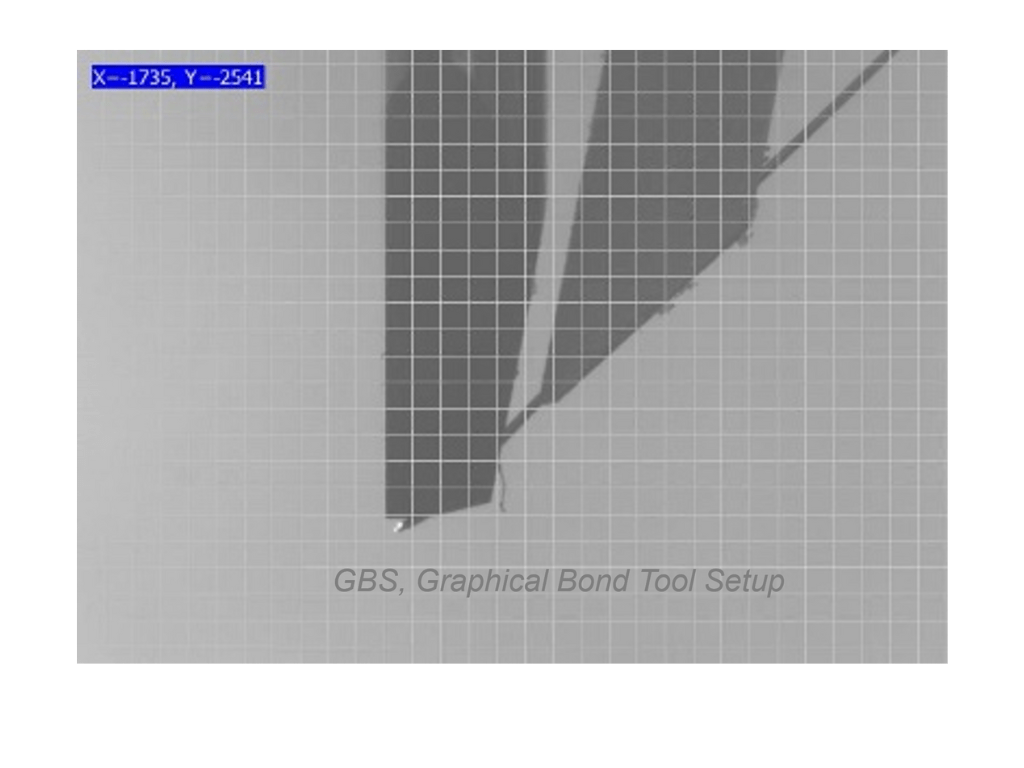
New graphical bond head set-up aid option (GBS) reduces consumable replacement time and ensures a repeatable set-up.
New graphical tooling set-up aid option reduces tooling set-up time and improves positioning.
Bond process monitoring option (BPM) helps keep tight control of the bonding process consistency.
SECS-GEM option for factory automation and communication.

